技术资料
09/01
2025


芯片制造工艺对性能的底层制约与突破路径
芯片制造工艺是将设计图纸转化为物理芯片的核心环节,其精度(如纳米制程)、稳定性与一致性直接决定芯片的开关速度、功耗密度与集成度,是影响芯片性能的硬件基础。从 28nm 到 3nm,每一代制程的突破都伴随着性能的显著提升,但也面临着物理极限与成本攀升的挑战
09/01
2025


芯片架构设计对性能的核心影响与优化方向
芯片架构作为芯片的 “骨架”,决定了指令执行效率、数据处理能力与资源分配逻辑,是影响芯片性能的底层因素。无论是 CPU、GPU 还是专用芯片(ASIC),架构设计的合理性直接关系到芯片在算力、功耗、延迟等核心指标上的表现
09/01
2025


IC 封装(DIP、SOP、BGA、COB)的选型策略与未来发展趋势
IC 封装的选型直接影响电子设备的性能、成本与可靠性,需结合应用场景、性能需求、生产效率综合判断;同时,随着芯片集成度提升与应用场景拓展,IC 封装技术正朝着高密度、高散热、微型化方向发展,需把握趋势以适配未来电子设备需求。
09/01
2025


COB 封装的裸芯集成、工艺难点与高可靠性应用
COB(板上芯片封装)是将裸 IC 芯片直接绑定在 PCB 上,通过引线键合或倒装连接实现电气连接,再用环氧树脂封装保护,具有体积小、成本低、集成度高的特点,广泛应用于 LED 显示、摄像头模组、医疗传感器等领域。需解决裸芯保护、工艺难点与可靠性保障问题
09/01
2025


BGA 封装的球栅阵列设计、焊接工艺与高频信号保障
BGA(球栅阵列封装)通过底部球形焊点阵列实现电气连接,具有引脚密度高、高频性能优、散热性好的特点,广泛应用于 CPU、GPU、FPGA 等高性能芯片,适配服务器、高端显卡、汽车电子等领域。
09/01
2025


SOP封装的小型化设计、工艺优化与消费电子应用
SOP(小外形封装)是在 DIP 基础上发展的表面贴装封装,引脚呈双列分布且贴装于 PCB 表面,具有体积小、密度高、高频性能优的特点,广泛应用于智能手机、平板电脑、可穿戴设备等消费电子领域
09/01
2025
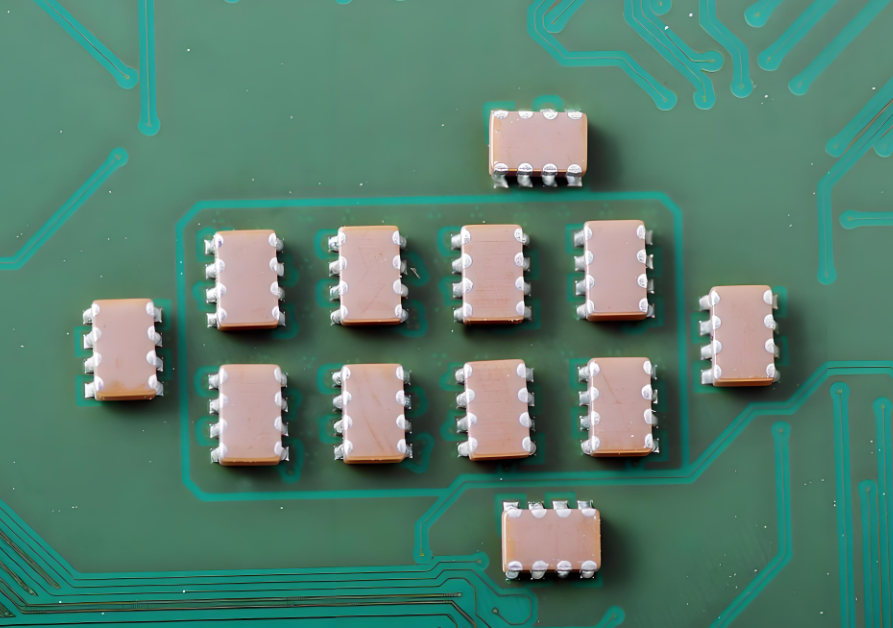
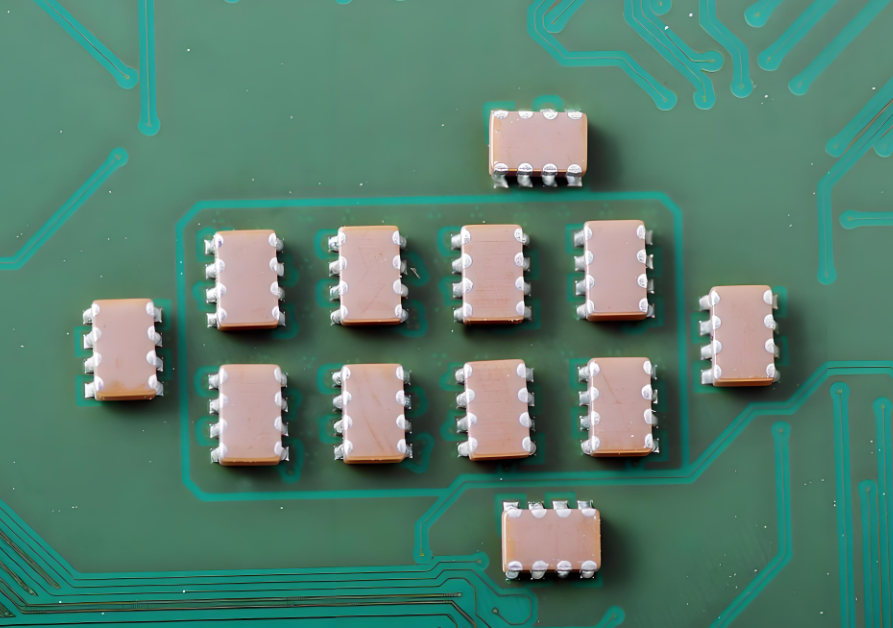
DIP封装的技术特性、工艺实现指南
DIP(双列直插式封装)作为传统 IC 封装形式,凭借结构简单、成本低、插拔便捷的优势,至今仍广泛应用于工业控制、家电设备等领域。其引脚呈双列分布且直插外露,需结合 PCB 直孔焊接实现电气连接,需从结构设计、工艺控制、场景适配三方面保障性能与可靠性。
 微信小程序
微信小程序




 浙公网安备 33010502006866号
浙公网安备 33010502006866号