6层PCB核心工艺流程与质量管控-PCB厂家指南
一、6 层板 PCB 工艺流程的复杂性与关键环节
6 层板 PCB 的生产流程比 4 层板多 “内层制作 - 层压 - 内层互连” 等关键环节,涉及 10 + 核心工序,任一环节失控都会导致批量不良(如层压分层、过孔开路):
核心挑战:多层对齐精度(偏差≤±0.05mm)、层间结合力(剥离强度≥1.0N/mm)、过孔可靠性(无空洞、无开路);
行业数据:6 层板生产良率通常比 4 层板低 5%-8%,主要失效点集中在层压(30%)、钻孔(25%)、沉铜(20%)。
PCB 厂家需建立 “工序标准化 - 参数监控 - 全检验证” 的管控体系,将良率提升至 95% 以上。
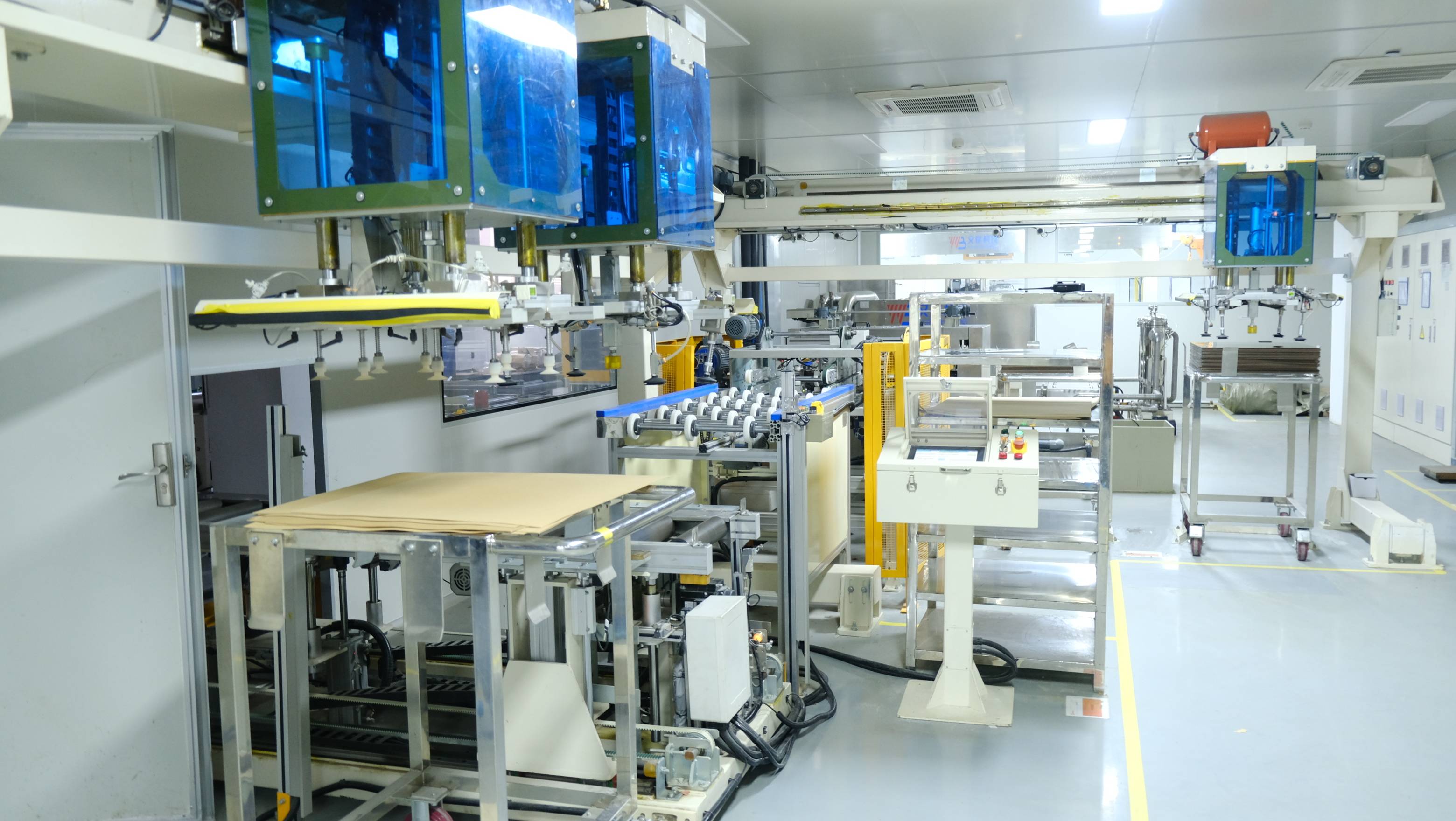
二、6 层板 PCB 核心工艺流程分步解析
(一)阶段 1:内层制作(L2-L5 层)
基材裁剪:
选用 1.2mm 厚 FR-4 基材(含双面铜箔),裁剪尺寸比成品大 5-10mm(预留层压收缩余量),尺寸偏差≤±0.1mm;
裁剪后进行边缘倒角(半径 0.5mm),避免层压时划伤半固化片(PP)。
内层图形转移:
清洗:碱性脱脂剂(浓度 5%-8%,40℃)超声清洗 5 分钟,去除铜箔表面油污(残留≤5mg/m2);
贴膜:压合干膜(厚度 35μm),温度 110℃±5℃、压力 0.5MPa,贴膜偏差≤±0.05mm;
曝光:紫外线曝光(能量 80-100mJ/cm2),菲林与基材对齐偏差≤±0.02mm,形成内层电路图形;
显影:1% 碳酸钠溶液(30℃)显影 60-90 秒,去除未曝光干膜,显影后电路边缘无锯齿(锯齿深度≤0.01mm);
蚀刻:酸性氯化铜蚀刻液(Cu2? 180-220g/L,50℃)蚀刻,蚀刻时间根据铜厚调整(35μm 铜箔需 60 秒),蚀刻后电路尺寸偏差≤±0.02mm。
内层 AOI 检测:
采用全自动 AOI(分辨率 5μm)检测内层电路,识别开路、短路、线宽偏差等缺陷,缺陷覆盖率≥99.8%,不合格品需返工(蚀刻过度需重新制作)。
(二)阶段 2:层压(多层合为一体)
叠层配置:
按叠层设计摆放 “外层基材(L1、L6)-PP - 内层基材(L2-L5)-PP”,PP 选用 2116 型(厚度 0.1mm)或 7628 型(厚度 0.2mm),确保总厚度达标(1.6mm±0.1mm);
放置定位销(精度 ±0.01mm),确保多层对齐偏差≤±0.05mm(内层与外层对齐偏差超 0.1mm 会导致过孔开路)。
层压参数控制:
升温阶段:室温→120℃(升温速率 2℃/min),预热 PP(软化温度 100-110℃);
加压阶段:120℃→180℃(升温速率 1℃/min),压力从 5kg/cm2 升至 30kg/cm2,确保 PP 完全流动(填充内层间隙);
固化阶段:180℃保温 60 分钟,PP 固化(交联度≥85%),形成稳定层间结构;
冷却阶段:180℃→50℃(冷却速率 3℃/min),避免降温过快导致 PCB 翘曲(翘曲度≤0.1%)。
层压后处理:
去毛刺:机械去毛刺(转速 3000rpm),去除层压后边缘毛刺(高度≤0.05mm);
厚度检测:用千分尺(精度 ±0.001mm)检测 PCB 厚度,每块板检测 5 个点(四角 + 中心),厚度偏差超 ±0.1mm 需重新层压。
(三)阶段 3:钻孔与孔金属化(实现层间互连)
钻孔工艺:
定位:采用 CCD 视觉定位(精度 ±0.01mm),识别 PCB 上的基准孔,确保钻孔位置偏差≤±0.02mm;
钻头选择:
普通过孔(孔径 0.3-0.6mm):选用硬质合金钻头(直径偏差 ±0.01mm),寿命 500-800 孔 / 支;
微小过孔(孔径≤0.2mm):选用钻石涂层钻头,寿命 1000-1200 孔 / 支,避免钻头磨损导致孔壁粗糙(Ra≤0.8μm);
钻孔参数:转速 20000-30000rpm,进给速度 50-100mm/min,避免孔壁出现撕裂(撕裂长度≤0.1mm)。
孔金属化(沉铜 + 电镀):
去钻污:碱性高锰酸钾溶液(浓度 60-80g/L,70℃)处理 10-15 分钟,去除孔壁树脂钻污(钻污残留≤5μm),确保沉铜结合力;
沉铜:化学沉铜(硫酸铜溶液,40℃),沉铜厚度 0.5-1μm,孔壁覆盖率 100%(无漏铜),沉铜后绝缘电阻≥101?Ω(500V DC);
电镀:酸性硫酸铜电镀,电流密度 1-1.2A/dm2,电镀时间根据铜厚调整(35μm 铜厚需 30 分钟),电镀后孔壁铜厚均匀性偏差≤±10%,无空洞(空洞率≤1%)。
(四)阶段 4:外层制作与表面处理
外层图形转移:
流程与内层类似,但需覆盖阻焊层区域,外层电路尺寸偏差≤±0.03mm(比内层宽松,因外层为信号层,精度要求略低);
蚀刻后进行外层 AOI 检测,重点排查过孔开路(过孔与外层电路连接不良)、线宽偏差。
阻焊层制作:
涂覆:丝网印刷阻焊油(厚度 15-20μm),或喷涂(适合复杂外形),涂覆均匀性偏差≤±2μm;
曝光显影:紫外线曝光(能量 100-120mJ/cm2),显影后阻焊层开窗尺寸偏差≤±0.03mm(确保焊盘露出);
固化:150℃烘烤 60 分钟,固化后阻焊层附着力≥0.8N/mm(3M 胶带测试),耐焊锡温度 260℃/10 秒无脱落。
表面处理:
沉金:金层厚度 0.1μm(信号焊盘),镍层厚度 2-3μm(阻挡层),沉金后接触电阻≤50mΩ;
热风整平(HASL):无铅焊锡(Sn-Ag-Cu),厚度 5-10μm,适合电源焊盘(载流能力强);
沉银 / 沉锡:适合中低端场景,成本比沉金低 30%,但耐腐蚀性略差(盐雾测试 48 小时无腐蚀)。
(五)阶段 5:终检与测试
外观检测:
全自动外观检测机(分辨率 10μm),检查阻焊层缺陷(气泡、漏印)、丝印错误(字符模糊、偏移)、表面处理缺陷(露铜、金层不均);
电气测试:
通断测试(ICT):检测开路、短路,测试覆盖率 100%;
阻抗测试:每批次抽样测试高速信号阻抗(偏差≤±5%);
绝缘电阻与耐电压测试:绝缘电阻≥101?Ω,耐电压 1500V DC/1 分钟无击穿;
可靠性测试:
抽样进行热循环测试(-40℃-125℃,100 次)、振动测试(10-2000Hz,20g,100 小时),测试后无分层、无过孔开路。
三、6 层板 PCB 生产的关键质量管控措施
工序参数监控:
层压:实时监控温度(偏差 ±2℃)、压力(偏差 ±1kg/cm2),每小时记录 1 次数据,异常时自动报警;
电镀:在线监测电镀液浓度(Cu2?偏差 ±5g/L)、电流密度(偏差 ±0.05A/dm2),确保铜厚均匀;
首件检验:
每批次生产前制作首件,进行全项检测(厚度、阻抗、电气性能),首件合格后方可批量生产,首件合格率≥98%;
追溯体系:
每块 PCB 赋予唯一追溯码,记录基材批次、层压参数、钻孔参数、测试数据,保存期≥3 年,便于后期故障排查(如某批次过孔开路,可追溯至钻孔钻头磨损);
持续改进:
每月分析不良数据(如层压分层主要因 PP 受潮),制定改进措施(如 PP 存储环境湿度≤40%),不良率每月降低 1%-2%。
 微信小程序
微信小程序




 浙公网安备 33010502006866号
浙公网安备 33010502006866号