HDI板(High Density Interconnector)即高密度互连板,采用微盲埋孔2和激光钻孔1技术,实现线宽/间距小于50μm的精细布线1,布线密度高1。它能显著提升信号完整性5和传输速率4,支持BGA等先进封装1。广泛应用于5G通信、智能手机、航空航天1及汽车电子等高端领域,是电子产品小型化、高性能化的理想选择
查看详情-
iPad三阶HDI板
 iPad三阶HDI板
iPad三阶HDI板板材:生益
层数:8层
板厚:1.2mm
最小线宽/线距:50/50um
最小板厚孔径比 8:1
表面工艺:沉金
-
16层存储服务器PCB板
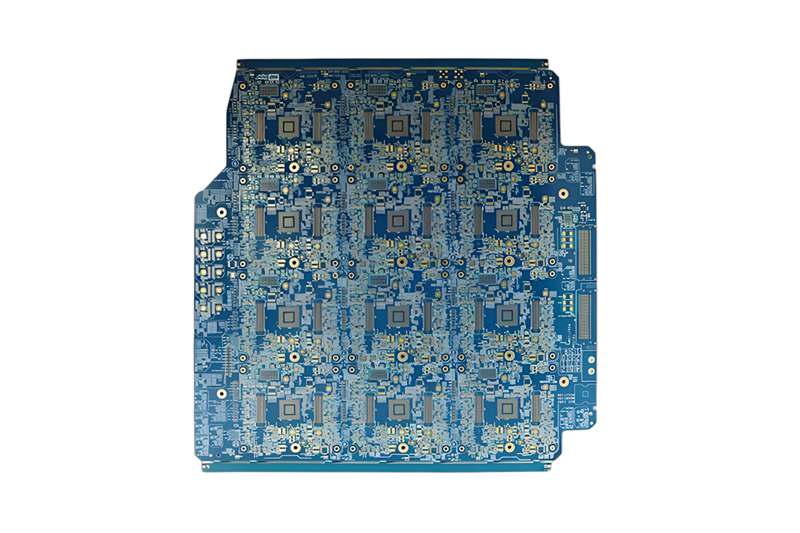 16层存储服务器PCB板
16层存储服务器PCB板层数:16层
板厚:3.2mm
表面处理:沉金
最小线宽/线距:3/3mil
-
6阶任意互联HDI埋盲孔线路板
 6阶任意互联HDI埋盲孔线路板
6阶任意互联HDI埋盲孔线路板板材:生益S1000-2M
层数:14层
板厚:1.6mm
最小线宽/线距:75/75um
最小孔径 激光孔:0.15mm;机械孔:0.20mm
表面工艺:沉金
-
3阶18层埋盲孔PCB电路板
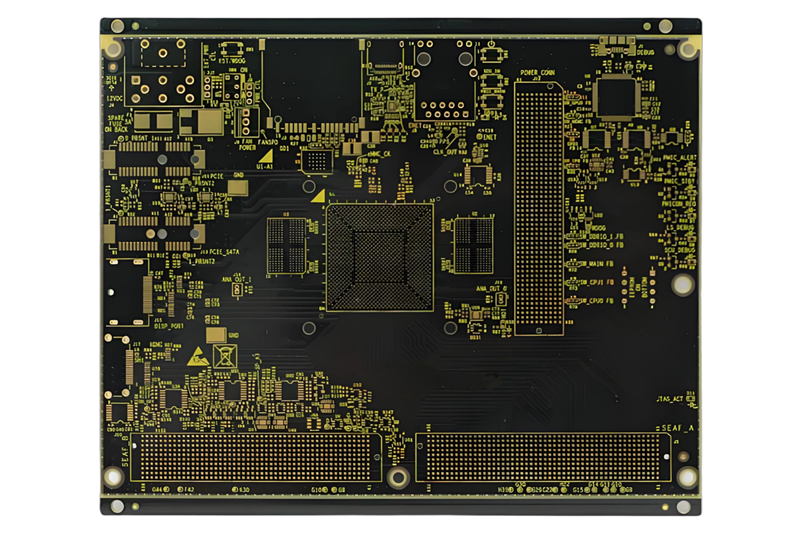 3阶18层埋盲孔PCB电路板
3阶18层埋盲孔PCB电路板板材:生益S1000-2M
层数:18层
板厚:2.1±0.21mm
最小孔径:11:1
最小线宽/线距:75/75um
-
游戏机主板PCB
 游戏机主板PCB
游戏机主板PCB层数:4层
板厚:1.0mm
表面处理:浸金(ENIG)
阻焊层:绿色
-
农用无人机电路板
 农用无人机电路板
农用无人机电路板材料:S1000-2M
层数:10层
厚度:1.0±0.1mm
最小孔径:激光盲孔0.1mm,机械孔0.2mm
最小轨道/间距:75/95um
最小板材厚度和孔比:5:1
表面处理:浸金(ENIG)0.05微米
-
7阶HDI盲埋孔PCB板
 7阶HDI盲埋孔PCB板
7阶HDI盲埋孔PCB板材料:S1000-2M
层数:16层
厚度:1.8±0.13mm
最小孔径:激光孔径 0.1mm
最小轨道/间距:75/75um
表面处理:浸金(ENIG)2u"
-
智能手机主板PCB
 智能手机主板PCB
智能手机主板PCB层数:10层
板厚:1.0mm
表面处理:OSP
阻焊层:哑光黑
-
三阶HDI PCB埋入式电阻电路板
 三阶HDI PCB埋入式电阻电路板
三阶HDI PCB埋入式电阻电路板材料:R5775G+IT180
层数:8层
厚度:2.0±0.2mm
最小孔径:激光盲孔0.1mm,机械孔0.2mm
最小轨道/间距:75/75um
最小板材厚度和孔比:10:1
表面处理:浸金(ENIG)0.05um
-
type-c接口PCB线路板
 type-c接口PCB线路板
type-c接口PCB线路板板材:FR4 高TG
板厚:0.8mm
铜厚:1OZ
颜色:绿油白字
表面工艺:沉金+OSP
最小线宽/线距:3mil/3mil
最小孔径:机械孔0.2mm,激光孔0.1mm
-
18层通讯高多层板
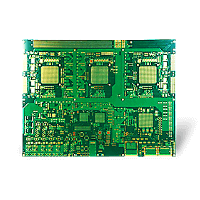 18层通讯高多层板
18层通讯高多层板层数:18L
板厚:3.0mm
表面处理:沉金
线宽线距:3/3mil
最小孔径:0.2mm
-
12层金手指显卡pcb线路板
 12层金手指显卡pcb线路板
12层金手指显卡pcb线路板层数:12层1阶
材质:TU872
工艺:沉金
最小钻孔:0.15mm
最小线宽:0.065mm
最小线距:0.065mm
 微信小程序
微信小程序




 浙公网安备 33010502006866号
浙公网安备 33010502006866号